csp器件,底部填充工艺会使得其性能变得更加可靠。在高产能的电子组装过程中需要高速精确的点胶。在许多芯片级封装的应用中,同时点胶系统必须根据胶体的使用寿命对材料的粘度变化而产生的胶量变化进行自动补偿。
芯片级封装是继TSOP、BGA之后内存上的新一代的芯片封装技术。半导体技术的进步大大提高了芯片中的晶体管数量和功能,这一集成规模在几年前还无法想象。下面我们要说的是点胶机、灌胶机之于芯片级封装中的应用。
点胶机、灌胶机在在芯片级封装中的应用早已不是先例。像手提电子设备中的 csp 器件就是点胶机、灌胶机的应用的一个重要分支。那么在芯片级封装中应用点胶机、灌胶机的过程中又应当注意哪些事项呢?
在焊接连接点的时候最好是使用底部填充工艺粘接 csp 器件,底部填充工艺会使得其性能变得更加可靠。在高产能的电子组装过程中需要高速精确的点胶。在许多芯片级封装的应用中,同时点胶系统必须根据胶体的使用寿命对材料的粘度变化而产生的胶量变化进行自动补偿。
在点胶过程中重中之重就要控制的就是出胶量,出胶量的多少影响着点胶质量,无论是胶量不够还是胶量过多,都是不可取的。在影响点胶质量堵塞同时又会造成资源浪费。在点胶过程中准确控制点胶量,既要起到保护焊球的作用又不能浪费昂贵的包封材料是非常关键的。


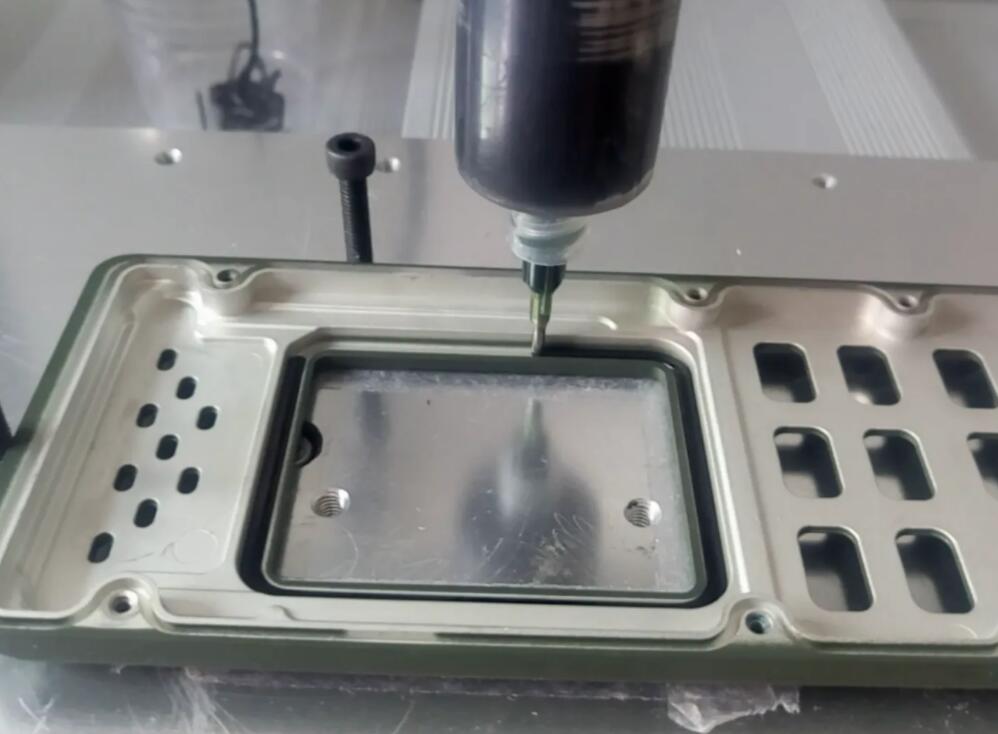

 网站二维码
网站二维码